
晶圆厚度测量及表面形貌
测量方案:晶圆厚度及表面形貌测量设备

测量方案:晶圆厚度及表面形貌测量设备
测量方式:非接触式对射法测量。
测量原理:光谱共焦测量通过使用特殊透镜,延长不同颜色光的焦点光晕范围,形成特殊放大色差,使其根据不同的被测物体到透镜的距离,会对应一个精确波长的光聚焦到被测物体上,通过测量反射光的波长,就可以得到被测物体到透镜的精确距离。
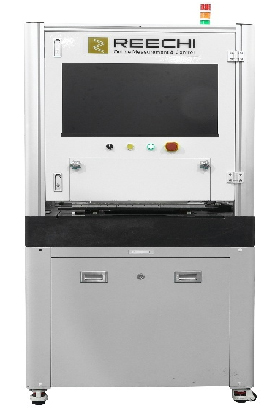
• 用于碳化硅、砷化镓、氮化镓、蓝宝石等;晶圆厚度、TTV(总厚度变化)、WARP(翘曲度)、BOW (弯曲度)等测量功能;
• 对射自动标定功能,亚微米级精密感知;
• 三点支撑,零损伤检测保障;
• 相机快速定位,精准检测;
• AI时刻学习,超强算法;
• 可定制自动化上下料;

米字线扫描
可自由设定扫描线数

脉冲线扫描
可自由设定线数、线间隔

网格点分布
可自由设定点数、位置

点扩散式分布
可设定点密集度



为客户提供满意测量解决方案